各センターが提供する装置
ニコンイメージングセンター
ナノテクDXセンター(微細加工)
ナノテクDXセンター(構造解析)
ニコンイメージングセンター
バイオイメージング装置
高速レーザー共焦点顕微鏡 A1

- 搭載レーザー:405nm, 488nm, 561nm, 633nm
- 電動XYステージ
- ステージインキュベーター
- パーフェクトフォーカスシステム
全反射蛍光顕微鏡・リアルタイム共焦点顕微鏡 Ti-E、EM-CCD

- 搭載レーザー:405nm, 488nm, 561nm, 633nm
- 共焦点ユニット: CSU-10
- 電動XYステージ
- ステージインキュベーター
- パーフェクトフォーカスシステム
多色蛍光タイムラプス顕微鏡 Ti-E

- 白色LED光源,
- 電動XYステージ
- ステージインキュベーター
- パーフェクトフォーカスシステム
超高速レーザー共焦点顕微鏡 A1Rsi

- 搭載レーザー:405nm, 488nm, 561nm, 633nm
- 電動XYステージ
- ステージインキュベーター
- パーフェクトフォーカスシステム
超解像顕微鏡 N-SIM

- 搭載レーザー:405nm, 488nm, 561nm, 633nm
- 電動XYステージ
- パーフェクトフォーカスシステム
高速多光子共焦点レーザー顕微鏡 A1 R MP
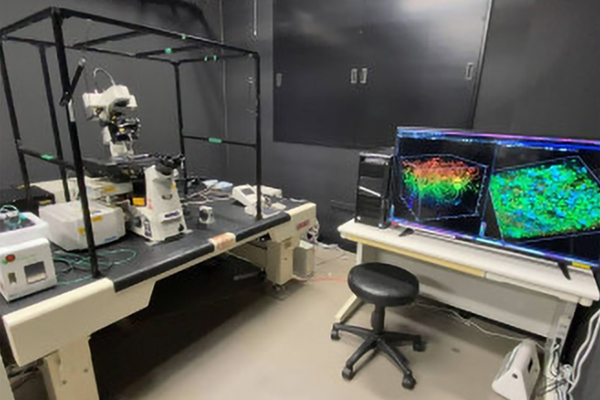
- 搭載レーザー(多光子用:IRパルスレーザー):Mai Tai DeepSee (700nm-1000nm)
- 搭載レーザー(共焦点用:半導体レーザー):405nm, 488nm, 561nm, 633nm
- 電動XYステージ
- ステージインキュベーター
- パーフェクトフォーカスシステム
AI画像解析システム AIVIA

- 人工知能(AI)技術を搭載した画像解析ソフトウエア
- 多次元データからのオブジェクト抽出
- 統計データ算出
ナノテクDXセンター(微細加工)
リソグラフィ装置
超高精度電子ビーム描画装置 ELS-F125U (エリオニクス)
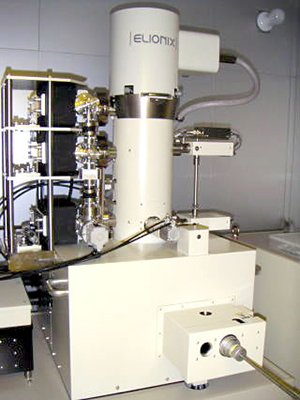
- 電子銃:ZrO/W熱電界放射型
- 加速電圧:125kV、75kV、25kV
- 試料サイズ:小片~最大φ6インチ
超高精度電子ビーム描画装置 ELS-7000HM(エリオニクス)
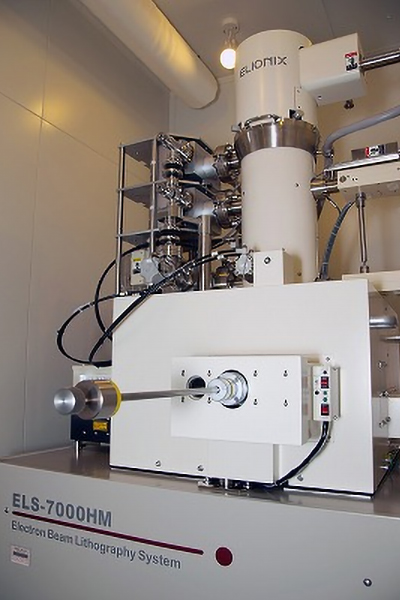
- 電子銃:ZrO/W熱電界放射型
- 熱電界放射型加速電圧:25、50、75、100kV
- 試料サイズ:小片~最大φ6インチ
超高速スキャン電子線描画装置 ELS-F130HM(エリオニクス)
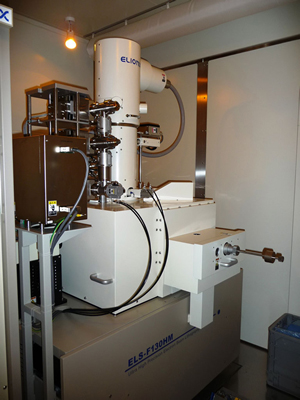
- 電子銃:ZrO/W熱電界放射型
- 加速電圧:130kV
- 試料サイズ:小片~最大φ8インチ
マスクアライナ MA-20(ミカサ)

- コンタクト露光
- 試料サイズ:小片~最大4インチ
- マスクサイズ:最大5インチ
レーザー描画装置 DWL66HK(ハイデルベルグ・インストルメンツ)

- 試料サイズ:小片~最大φ9インチ
- 最大描画エリア:8インチ
- 最小描画線幅:0.3ミクロン(HiRes)、0.8ミクロン(WMII)
- 255階調グレースケールモード搭載
- バックアライメント機能
成膜装置
真空蒸着装置 ED-1500R(サンバック)

- 蒸着源:抵抗加熱3元、EB3元
- 基板加熱可
- 水晶振動式膜厚計
プラズマCVD装置 PD-220ESN(サムコ)
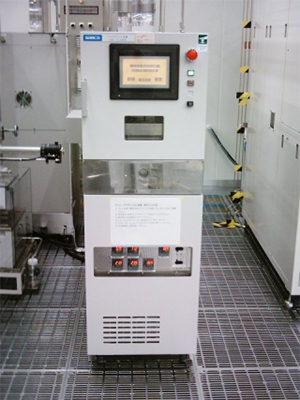
- 試料種類:SiO2、SiN
- 試料サイズ:小片~最大φ8インチ
液体ソースプラズマCVD装置 PD-10C1(サムコ)
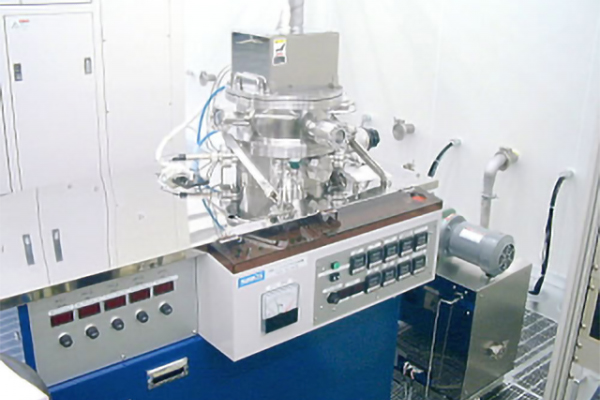
- 試料種類:SiO2他
- キャリアガス:N2、He、Ar、H2
- 試料サイズ:小片~最大φ3インチ
ヘリコンスパッタリング装置 MPS-4000C1/HC1(アルバック)
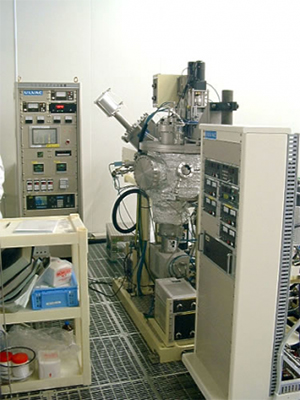
- 試料種類:3元、Au、Ag、Cr、Ti、SiO2、他
- カソード(対向):2インチ 2元、4インチ 1元
- 基板サイズ:小片~最大φ100mm
多元スパッタ装置 QAM-4-ST(アルバック)
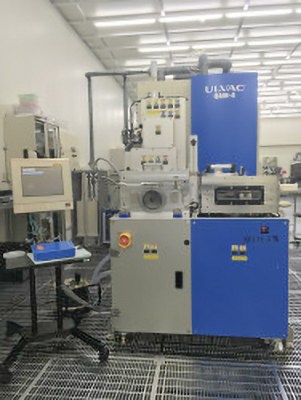
- 成膜材料:Au、Cr、Pt、Ag、Ti、Al他
- カソード:7元(4元+3元)
- 基板サイズ:小片~最大φ100mm、対向25mm角
- 逆スパッタ、コスパッタ(DC/RF)対応
- ラジカルガン(O2、N2)
- 700度加熱可能
マニュアルスパッタ

- カソード:2元(RF2インチ、DC1インチ)
- 基板サイズ:小片~最大φ2インチ
- 対向成膜
電子ビーム蒸着装置 EB-580S(EIKO)

- 蒸着源:Au,Ti,Al,Cu,Nb他
- 基板加熱:600℃程度まで
- 水晶振動式膜厚計
イオンビームスパッタリング装置 IBS-6000S(アルバック)
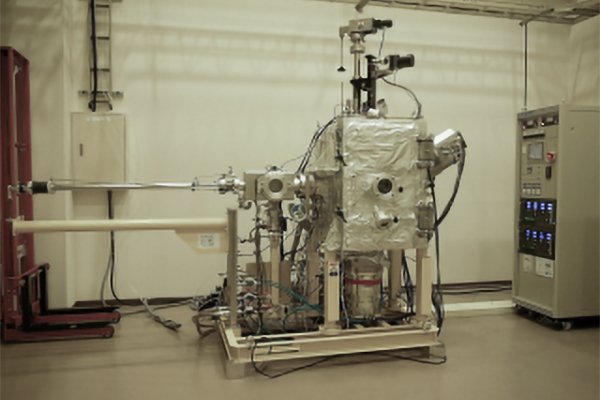
- 成膜材料:4元、Ni,Cr,SiO2、W-Si他
- 基板サイズ:最大φ3インチ、厚さ最大20mm
- 基板加熱:最大600℃
- 逆スパッタ
コンパクトスパッタ装置 ACS-4000-C3-HS(アルバック)

- 試料種類:SiO2、Au、Cr等
- カソード:オート3元、マニュアル1元
- 基板サイズ:社入射小片~φ4インチ、対向25mm角まで
- 基板加熱:最大550℃
- コスパッタ
原子層堆積装置 SUNALE-R(ピコサン)

- 成膜材料:SiO2、TiO2、Al2O3、Nb2O5他
- 酸化剤:H2O、O2、オゾン
- 試料サイズ:小片~最大φ6インチ
- 成膜温度範囲:最大600℃
原子層体積装置(粉末対応型) R-200 advanced(ピコサン)
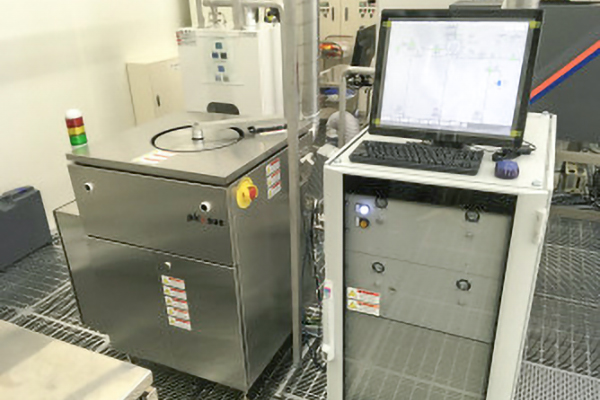
- 成膜材料:TiO2、Al2O3他
- 酸化剤:O2
- 試料サイズ:小片~最大φ8インチ、粉末サンプル
- 成膜温度範囲:最大600℃
プラズマ式原子層体積装置 AD-230LP-H(サムコ)

- 成膜材料:SiO2、TiO2、Al2O3他
- 試料サイズ:最大8インチ
- ステージ温度範囲:最大500℃
- 反応剤:H2O、O3、O2プラズマ、N2プラズマ、NH3プラズマ、H2プラズマ
半導体薄膜堆積装置 PAC-LMBE(パスカル)
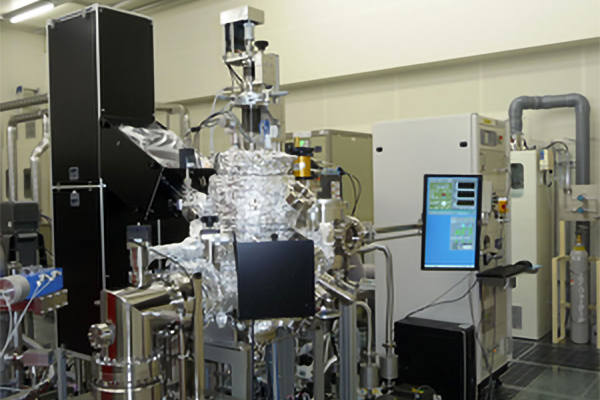
- 光源:エキシマーレーザー248nm
- 試料種類:TiO2、SrTiO3など
- 試料サイズ:2cm角
- 基板加熱可能
エッチング装置
ICP高密度プラズマエッチング装置 RIE-101iPH(サムコ)
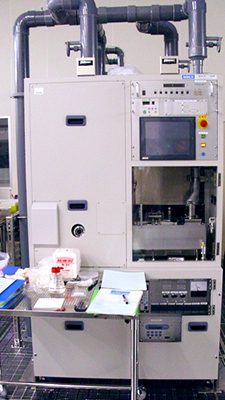
- 使用ガス:SF6、CF4、Ar、O2、CHF3、C3F8
- 試料サイズ:最大4インチ
ICP高密度プラズマエッチング装置 RIE-101iHS(サムコ)
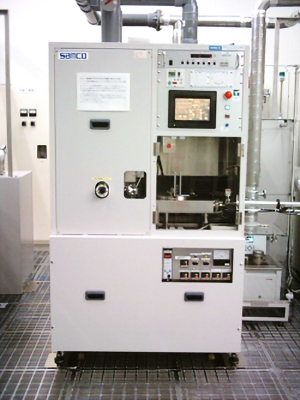
- 使用ガス:Ar、O2、SiCl4、Cl2
- 試料サイズ:最大4インチ
シリコン深掘りエッチング装置 APX-ASE-Pegasus-Polestar(SPPテクノロジーズ)
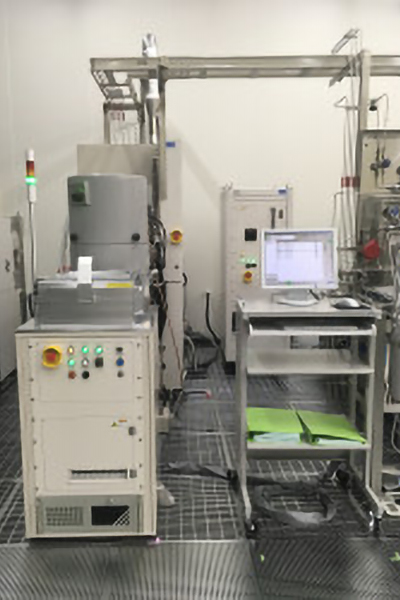
- 使用ガス:SF6、C4F8、Ar、O2
- 基板サイズ:小片~φ4インチ
ドライエッチング装置 NLD-500(アルバック)
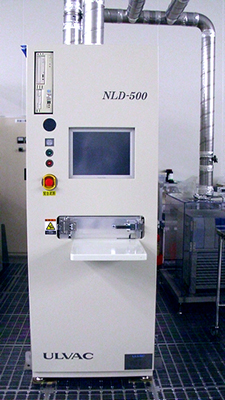
- 使用ガス:CHF3、SF6、C4F8、O2、Ar
- 試料サイズ:最大4インチ
反応性イオンエッチング装置 RIE-10NRV(サムコ)

- 使用ガス:CF4、Ar、O2、CHF3
- 試料サイズ:最大8インチ
イオンミリング装置 IBE-6000S(アルバック)
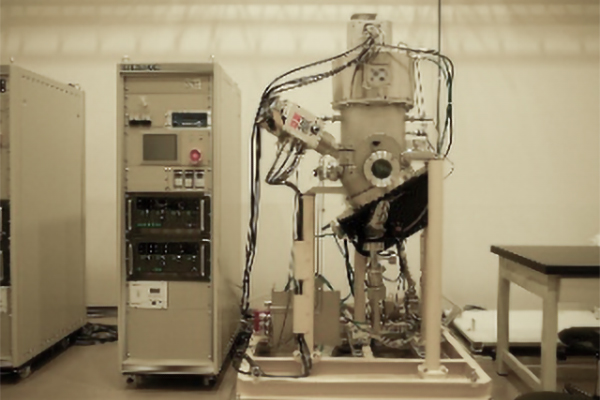
- 使用ガス:Ar
- 試料サイズ:最大φ3インチ、厚さ最大20mm
- チルト:0度~60度
フッ化キセノンドライエッチング装置 VPE-4F(サムコ)

- 反応ガス:XeF2
- ガス圧力:400Pa
- 反応室:Al製、φ150mm(内径)
評価装置
高分解能電界放射型走査型電子顕微鏡 JSM-6700FT(日本電子)
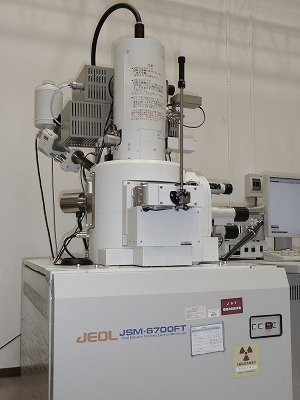
- 加速電圧: 0.5 ~30kV
- 倍率:×25~19,000 (LM mode)、×100~650,000 (SEM mode)
- EDS機能、2探針マイクロプローブ装備
その他共用装置
太陽電池評価システム WXS-156SL2,AM1.5GMM(ワコム電創社)
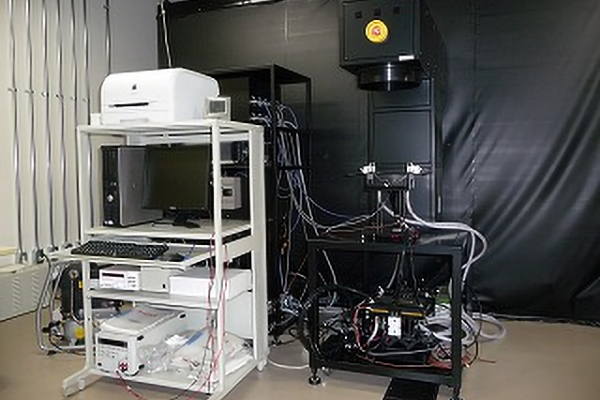
- JIS、IEC規格準拠 CLASS AAA
- 照射強度: 1(sun)
- 基板サイズ:最大6インチ角
真空紫外露光装置 フォトクリエーターPC-01-H(エヌ工房)
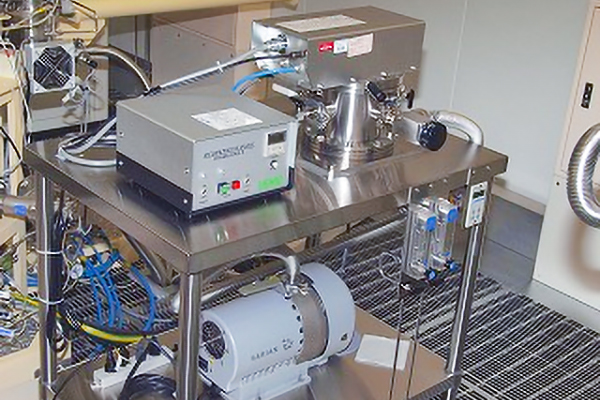
- 試料サイズ:最大1インチ
レーザー顕微鏡 VK-9700/9710(キーエンス)

- 対物レンズ 10,x20,x50,x150
- レーザー波長 408nm
UV-オゾンクリーナー UV-1(サムコ)

- 試料サイズ:最大φ200mm
- ステージ温度範囲:室温~最大300度
- 紫外線ランプ波長:254nm
- 無声放電方式高濃度オゾナイザ
光学干渉式膜厚計 F20-UV(フィルメトリクス)

- 膜厚測定範囲:数nm~40μm
- 波長範囲:200~1100nm
- サンプルサイズ:φ3mm以上
- 光源:ハロゲンランプ、重水素ランプ
ガラスインプリント装置 GMP-415V(芝浦機械)

- 温度範囲 0℃~800℃ (室温~800℃)
- 温度制御時間:0~999sec
- 軸ストローク:0~85mm
- プレス力:0~40 kN
- 軸速度:0~15 mm/sec
- 真空到達度:0.001~100 Pa
- サンプルサイズ:25mm角
卓上型ランプ加熱装置 MILA-5000-P-N(アルバック)

- 温度範囲:室温 ~ 1200℃
- 試料寸法:角 20mm × 厚 2mm
- 加熱雰囲気:大気中、真空中、不活性ガス中
- 使用ガス:N2、Ar、O2
- 到達真空度:6.5Pa(RP使用、室温無負荷)
微細形状想定装置 ET200(小坂研究所)

- 試料サイズ:最大 Φ6インチ、厚さ52mm
- 微小測定力検出器:最小10μN(1mgf)
- 水平方法読取:分解能0.1μmデジタルスケール
ナノテクDXセンター(構造解析)
構造解析装置
超薄膜評価装置 STEM HD-2000(日立ハイテク)

- 加速電圧:200kV(冷陰極電界放出電子銃)
- 格子分解能:0.24nm
- 倍率:×100~5,000,000
- 分析機能:EDS、EELS
- SEM観察像:2次電子観察、STEM観察、明視野像暗視野像
超高速時間分解光電子顕微鏡システム TR-PEEM(エルミテック)
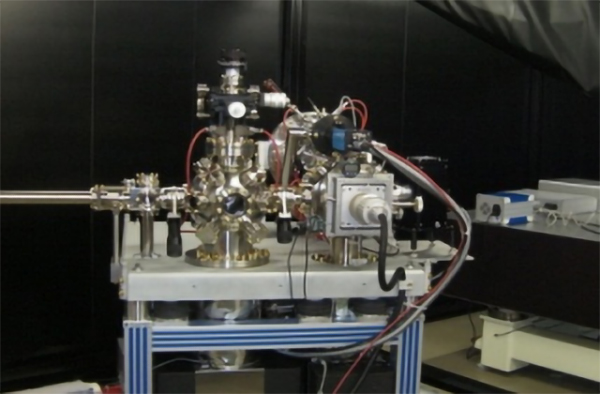
- 空間分解能:4nm以下
- エネルギー分解能:150meV以下
- 視野範囲:2~180μm
- 時間分解能:7fs以下
- レーザー波長:400nm,800nm
- 5軸ステージサンプル加熱機構あり
収差補正走査型透過電子顕微鏡 JEM-ARM200F(日本電子)

- 加速電圧:80kV、200kV(ColdFEG)
- 分析機能:EDS、EELS
- 大気非暴露、冷却試料ホルダー
- 遠隔観察
集束イオンビーム加工観察装置 FIB FB-2100(日立ハイテク)

- 加速電圧:Ga 5kV~40kV
- 最高倍率:×280,000
- SIM分解能:6.0nm
- 3次元ホルダー及びコントローラー、マイクロサンプリング機構付属
超高分解能走査型電子顕微鏡 SU8230(日立ハイテクノロジーズ)

- 電子銃:冷陰極電界放射型電子銃(ColdFE)
- 加速電圧:0.1~30kV
- 倍率:×20~2,000,000倍
- 分析機能:EDS
- 試料ホルダー:最大150mm×10mm(H)
- STEM機能
X線光電子分光装置 JPS-9200(日本電子)
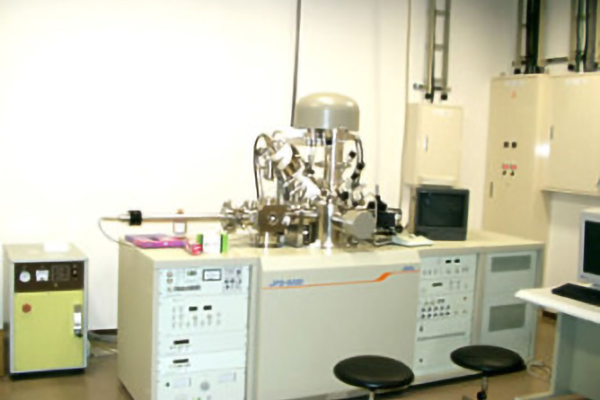
- 単色化X線源
- 入射レンズ 視野制限及び角度制限絞り組込 磁界電界形インプットレンズ
- 静電半球形アナライザ 中心軌道半径100 mm
- 検出器 マルチチャンネルディテクタ
- 試料サイズ: 10 mm × 10 mm.厚さ2 mm以内
結晶分子構造解析装置 IRT-3000N
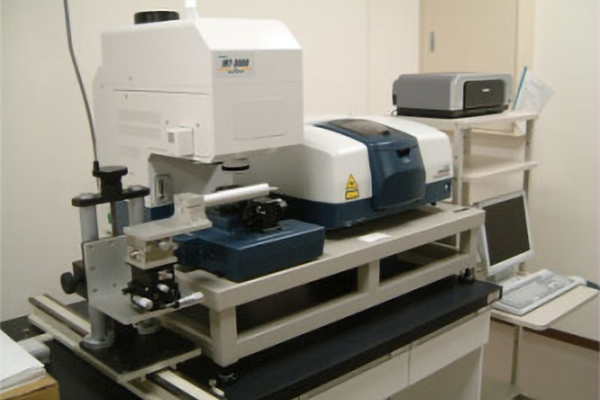
- 対物レンズ:10X,16X or 32X カセグレン.
- ステージ駆動範囲t: X:70mm, Y:50mm, Z:20 mm.
- 測定範囲:15000-200cm-1.
大気中光電子分光装置 AC-3(理研計器)

- 測定エネルギー範囲:4.0eV~7.0eV
- 測定スポットサイズ:2×5mm
- 試料サイズ:最大30×30mm(厚さ10mm )
精密イオンミリングシステム PIPSⅡmodel 695(Gatan)

- 加速電圧範囲:100eV ~6keV
- 試料サイズ:3mm
- 試料回転:1~6rpm まで可変
- X,Y切換え範囲:±0.5mm
- 試料冷却:-120℃まで可能
顕微紫外可視分光装置 MSV-5200(日本分光)

- 反射、透過測定
- 光電子増倍管、冷却型PbS光導電素子
- 測定波長域:200nm-2700nm
- カセグレン対物32倍
- 自動XYZステージ
紫外可視分光光度計(積分球付き) UV-3600i Plus/MPC-603A(島津製作所)

- 測定波長範囲:(直接受光)200 ~ 3300 nm (積分球) 220 ~ 2600 nm
- 最高分解 : 0.1nm
- 測光方式 : ダブルビーム
- 検出器 : PMT、InGaAs、Pbs
- マルチパーパス大型試料室 MPC-603A 付
- 透過試料 φ305mm×50mmtまたは φ204mm×300mmt
- 反射試料 φ305mm×50mmt
分光蛍光光度計 F-7100(日立ハイテク)

- 測定波長範囲(励起、蛍光側共) 200~750 nmおよび0次光
- バンドパス 励起側、蛍光側:1、2.5、5、10、20 nm
- 分解 1.0 nm(at 546.1 nm)
- 積分球付
- 測光方式:単色光モニター比演算方式
- 光源 :150 W Xeランプ オゾン自己解消ランプハウス
ラマンイメージング装置 HR-Evolution type pa nano(堀場製作所)
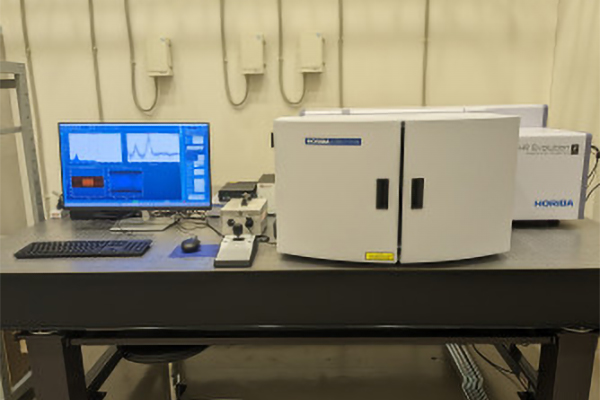
- レーザ(ラマン分析用光源):励起波長 633nm
- 測定波長範囲:100-4000cm-1
- 分光器:入射スリット:0~1000μmまで、1μmステップ(電動制御)
- 検出器: CCD検出器 (Open Electrodeタイプ)
- 対応波長: 200~1050nm
- 顕微鏡部:×5,×10,×100










